在后疫情时代里,数字化技术的普及应用会进 步将人们的衣食住行等生活信息、气候变化等环境信息以及企业运营信息编制到 个巨型网络中进行 元管理,并从中发掘新的价值。我们称之为“万物相连时代”。FUJI作为创造时代的亲历者,正在积 发展融入数字孪生解决方案的表面贴装技术,开创新的机遇。此篇 为各位总结2021年表面贴装技术的发展趋势。
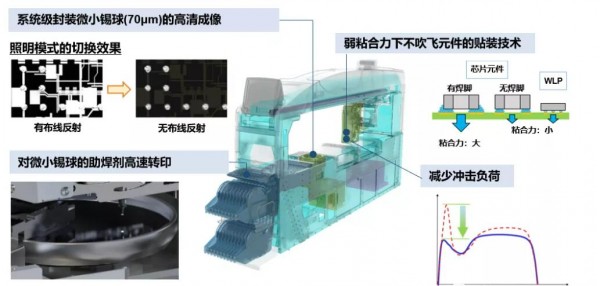
SMT元件的变化趋势
由于智能手机、智能手表等通信终端的功能与性能不断提高、5G和IoE的广泛应用、网络基础设施和传感器设备的增加以及电动汽车的普及,使在单个产品上的电子元件贴装数量不断增加。本章将向各位介绍SMT元件的尺寸演变趋势和半导体封装的发展趋势。
根据JEITA电子技术产业协会的2019年度表面贴装技术规划图,我们可以看到2018年多层陶瓷电容器的组成比例达到了0603M和1005M的交叉点,其中0603M的组成比例 高。日后为了提高智能手机的功能并确保电池的搭载空间,将需求更小和更立体的贴装区域。因此,0402M的构成比例有望继续增长,预计到2025年达到20%左右, 0201M元件也会在2022年开始面向普及。除了无源元件的小型化,相邻元件之间的距离也在逐年缩小,预计到2024年将达到50微米左右。这时,当将元件贴装到间隙窄小的电路板上时,如果吸嘴前端接触面大于元件的吸取面,则吸嘴前端可能会与相邻的已贴装元件发生干涉而导致贴装不良。回避上述问题的关键在于合理的吸嘴设计以及吸嘴的选用,我们日后将进 步提高对贴装品质的管控,在确保质量的前提下不断研发更加高速和高精度的贴片机,让客户能够放心地使用FUJI设备。
接下来介绍半导体封装的发展趋势。半导体封装正变得越来越薄型化,贴装间距也越来越小。比如,大型QFP(Quad Flat Package)逐渐被BGA(Ball Grid Array)取代,小型QFP也逐渐演变为QFN(Quad Flat Non-leaded)、WLP(Wafer Level Package)。另 方面,加工服务器主板时则需要完成对大型重型的BGA的贴装,目前为止,我们使用模组型高速多功能贴片机NXT的标准规格上限的102mm,特殊规格的150mm能够应对上述需求。据推测,日后随着电子产品性能的提高,贴装元件有多脚化的趋势,但根据实际应用,元件的尺寸与重量特征也会根据情况发生变化。
以上,我们对SMT元件的变化趋势以及半导体封装的贴装方案进行了阐述,下 期将在此基础上介绍FUJI如何通过数字孪生技术推进智能工厂的发展。我们下期不见不散!







